TSV Технологические услуги
TSV (кремниевое отверстие) - это передовая технология инкапсуляции, которая обеспечивает интеграцию различных функциональных чипов, позволяя кремниевым каналам проходить вертикально через различные чипы или слои, составляющие стопку. TSV в основном заполняет медь и другие проводящие материалы для завершения вертикального электрического соединения через отверстие кремния, уменьшает задержку сигнала, уменьшает емкость и индуктивность, реализует низкое энергопотребление чипа, высокоскоростную связь, увеличивает пропускную способность, реализует потребность в миниатюризации интеграции устройства.
Раньше большинство соединений между чипами были горизонтальными, и создание TSV позволило вертикально складывать несколько чипов. Привязка к проводам и перевёрнутый выпуклый блок чипа обеспечивают электрическое соединение за пределами сердечника, RDL (перенаправленная проводка) обеспечивает горизонтальное соединение внутри сердечника, а TSV обеспечивает вертикальное соединение внутри чипа.
TSV в основном используется в трех направлениях: заднее соединение, 2.5D инкапсуляция, 3D инкапсуляция.
Вертикальное обратное соединение. Безчиповый стоп, например, « простое заднее соединение». TSV находится в активной трубке и используется для сварки диска, соединенного с обратной стороной чипа.
2.5D Упаковка. сердечник соединен с кремниевым промежуточным слоем, TSV находится в промежуточном слое.
Пакет программного обеспечения 3D. TSV находится в активном сердечнике трубки, чтобы обеспечить укладку чипов.
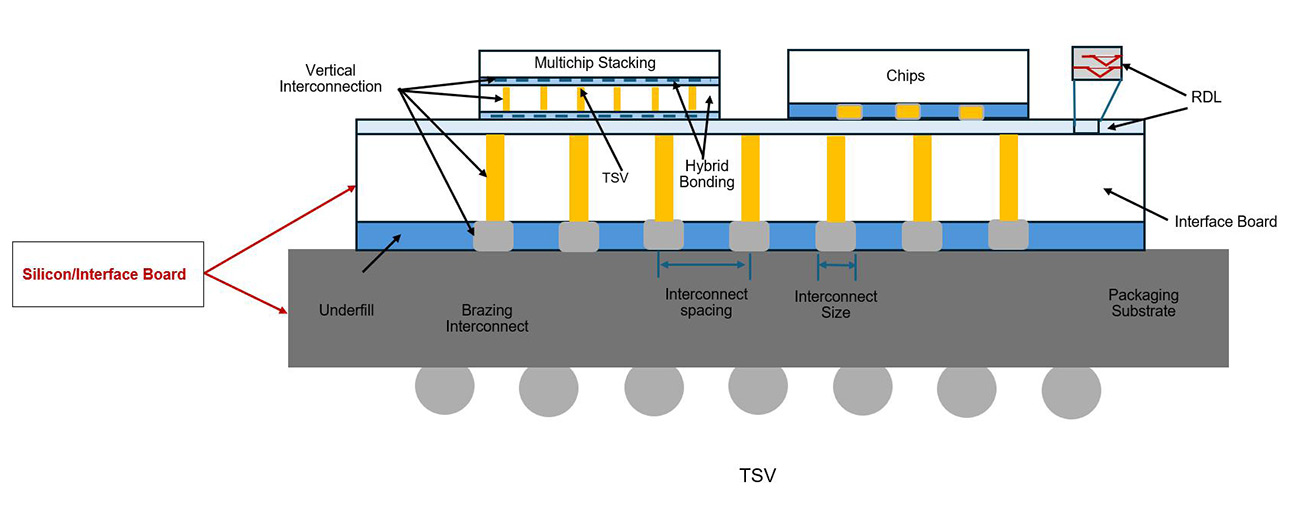
Наш процесс:
Пористость: Пористость может быть выполнена с помощью лазерного бурения, сухого травления, мокрого травления и т. Д.
Осадок изоляционного слоя: Внутренняя изоляция отверстия TSV используется для обеспечения изоляции между кремниевой базой и каналом передачи внутри отверстия, чтобы предотвратить утечку и последовательные помехи между отверстиями TSV.
Осадки барьерного / семенного слоя: Медный проход часто используется в качестве внутреннего металлического соединительного материала для отверстий TSV в межслойном процессе 2,5D TSV.
Заполнение покрытия: Заполнение глубоких отверстий TSV является ключевой технологией 3D - интеграции, которая напрямую связана с электрическими характеристиками и надежностью последующих устройств. Материалы, которые могут быть заполнены, включают медь, вольфрам, поликристаллический кремний и так далее.
CMP (Химическая механическая полировка): Технология CMP используется для удаления диэлектриков диоксида кремния, блокирующих и кристаллических слоев с поверхности кремния.
Уменьшение кристаллического круга: После выравнивания поверхности чипа задняя часть чипа уменьшается, чтобы выставить TSV.



